Từ DIP đến Chiplet:
Đằng sau sự tiến hóa công nghệ đóng gói bán dẫn, logic đổi mới vật liệu của Earlysun
🔬 Đóng gói chip · Lặp lại công nghệ · Vật liệu tiếp sức
Mỗi bước đột phá của ngành công nghiệp bán dẫn đều không thể tách rời sự lặp lại phối hợp của toàn chuỗi "Thiết kế - Chế tạo - Đóng gói". Nếu nói thiết kế chip là "định nghĩa hiệu suất", chế tạo là "hiện thực hóa tiềm năng", thì đóng gói chính là "giải phóng giá trị" — nó không chỉ quyết định hình thái vật lý và khả năng thích ứng ứng dụng của chip, mà còn ảnh hưởng trực tiếp đến hiệu quả truyền tín hiệu, khả năng tản nhiệt và độ tin cậy lâu dài.
Từ đóng gói cắm trực tiếp DIP thời kỳ đầu đến đóng gói Chiplet ngày nay, nhu cầu cốt lõi của sự tiến hóa công nghệ luôn xoay quanh "nhỏ hơn, nhanh hơn, tin cậy hơn", và đằng sau tất cả sự thay đổi này đều không thể thiếu sự hỗ trợ đổi mới của vật liệu đóng gói.
I. Sự tiến hóa công nghệ đóng gói bán dẫn: Từ "bao bọc đơn giản" đến "tích hợp hệ thống"
Sự phát triển của công nghệ đóng gói bán dẫn, về bản chất là sự phản hồi liên tục đối với độ tích hợp chip và nhu cầu ứng dụng, đại khái có thể chia làm ba giai đoạn then chốt:
1. Đóng gói truyền thống: Lấy "bảo vệ cơ học + kết nối cơ bản" làm cốt lõi
Các công nghệ thời đầu như DIP, SOP, QFP, mục tiêu cốt lõi là kết nối vật lý và bảo vệ cơ học. Khoảng cách điểm hàn rộng (thường ≥0.5mm), yêu cầu cốt lõi đối với vật liệu là "tương thích mạnh, quy trình trưởng thành".
2. Đóng gói tiên tiến: Lấy "kết nối mật độ cao + thu nhỏ" làm cốt lõi
Các công nghệ FlipChip, BGA, CSP ra đời. Khoảng cách điểm hàn thu nhỏ xuống 0.3~0.5mm, đặt ra yêu cầu "độ chính xác cao, ít lỗi" đối với vật liệu: kem hàn cần kích thước hạt bột mịn hơn, keo underfill cần tính chảy cao.
3. Đóng gói tiền tuyến: Lấy "tích hợp hệ thống + hiệu suất cao" làm cốt lõi
Chiplet, 3D IC trở thành điểm nóng. Đóng gói nâng cấp thành "tích hợp hệ thống đa chip", khoảng cách điểm hàn thu nhỏ xuống cấp micron. Vật liệu cần có: năng lực kết nối mật độ cao, hệ số giãn nở nhiệt (CTE) cực thấp, hiệu suất tản nhiệt ưu việt.

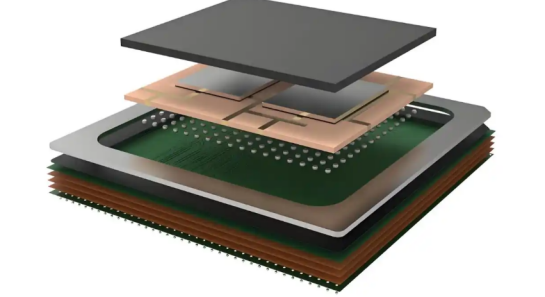
II. Đổi mới vật liệu theo kịch bản: "Giải pháp thích ứng đóng gói" của Earlysun Technology
Sự khác biệt về nhu cầu cốt lõi của các công nghệ đóng gói khác nhau quyết định sự đổi mới vật liệu phải "đúng bệnh bốc thuốc". Earlysun Technology dựa trên sự hiểu biết sâu sắc về sự tiến hóa công nghệ đóng gói, đã nghiên cứu phát triển có mục tiêu dòng vật liệu đóng gói toàn diện:
🏗️ Kịch bản đóng gói truyền thống: "Đảm bảo cơ bản" ổn định tin cậy
Nhắm vào các quy trình DIP, QFP..., kem hàn tương thích cao loại phổ thông và nhựa epoxy dùng cho đóng gói của Earlysun Technology có ưu thế cốt lõi nằm ở "khả năng thích ứng quy trình mạnh, hiệu suất ổn định". Nhựa epoxy đóng gói có tính chảy và tỷ lệ co ngót khi đóng rắn tốt, đảm bảo chip vận hành ổn định lâu dài trong môi trường thông thường.
🚀 Kịch bản đóng gói tiên tiến: "Nâng cấp hiệu suất" đột phá chính xác
Keo underfill CTE thấp nhắm vào vấn đề ứng suất nhiệt của chip lật (flip-chip), sử dụng công thức nhựa epoxy biến tính, hệ số giãn nở nhiệt (CTE) thấp tới dưới 15ppm/℃, phù hợp cao độ với đặc tính giãn nở nhiệt của chip và đế, có thể hấp thụ hiệu quả ứng suất sinh ra trong quá trình chu trình nhiệt, giảm hơn 80% nguy cơ đứt gãy điểm hàn.

Cùng với việc ngành công nghiệp bán dẫn tiến vào "thời đại hậu Moore", các công nghệ như Chiplet, 3D IC, liên kết lai (hybrid bonding) sẽ trở thành hướng đi chủ đạo trong lĩnh vực đóng gói.
Earlysun Technology sẽ tiếp tục tăng cường đầu tư R&D vật liệu đóng gói tiền tuyến, bám sát nhịp độ lặp lại công nghệ. Từ đóng gói truyền thống đến đóng gói tiên tiến, sự đổi mới vật liệu của Earlysun Technology luôn lấy "tiếp sức cho ngành" làm cốt lõi, tiếp tục lấy đổi mới công nghệ làm động cơ, đóng góp sức mạnh vật liệu Trung Quốc cho sự phát triển chất lượng cao của ngành công nghiệp bán dẫn toàn cầu.



